微电子所等在氮化镓界面编辑方面取得进展
2021-02-24
微电子研究所
【字体:大 中 小】

语音播报

近日,中国科学院微电子研究所高频高压中心研究员刘新宇团队与中科院合肥物质科学院固体物理研究所研究员刘长松团队、微电子所先导中心工艺平台合作在GaN界面编辑领域取得进展,揭示低压化学气相沉积(LPCVD)SiNx/GaN界面晶化的形成机理,在理论上创新定义了θ-Ga2O3结构,并将1ML θ-Ga2O3薄层插入界面调控未饱和原子化学键,进而有效抑制了界面带隙电子态密度。
对于下一代平面和垂直型GaN电子器件,能否将薄膜介质集成到III-N材料中至关重要,高质量界面和对电应力的高耐受性是薄膜材料选择的主要标准和潜在挑战。目前,在III-N表面已采用多种材料作为钝化和栅极介电层以提高器件性能和可靠性,其中包括团队前期研究的LPCVD-SiNx介质,其具有高温耐受性、结构致密、无离子损伤、高TDDB特性等优势。但由于高沉积温度(约780°C)和非故意氧残留,在SiNx沉积过程中会发生复杂反应,导致界面处存在混合成分,包括非晶相和结晶相,甚至是不连续的产物。从能量角度考虑,这种扭曲的局部键和无序粗糙晶化物质会导致带隙中高电子态密度,进一步导致意外的电流崩塌或表面泄漏电流。将无序晶化区域最小化并获得晶态向非晶态的急剧转变是最小化态密度的潜在方法之一。根据之前的研究结论,LPCVD-SiNx /GaN界面之间晶化相Si2N2O形成机理与调控技术值得研究。另一方面,即使在界面上合成了完全有序的Si2N2O晶体,仍然存在较为明显的近导带态密度,需要对界面进行原子级编辑,以期找到界面原子键态饱和的定量定义,从而指导界面态抑制工作。
该研究通过高分辨率X射线光电子能谱技术,解析了LPCVD-SiNx/GaN界面反应物和生成物的化学成分,分析了界面部分晶化超薄层的形成机理;结合反应吉布斯自由能变化的可行性分析,提出了一个合理的生成Si2N2O的化学反应方程式,并认为GaN表面高能活化的Ga2O可能有助于结晶成分的合成;创新定义了θ-Ga2O3结构,并将1ML θ-Ga2O3过渡层插入Si2N2O / GaN界面超胞结构中,用于编辑界面未饱和的化学键。该项研究在理论上证明,当界面不饱和原子的有效电荷数调整到一定区间时,界面可以实现低态密度水平。
该工作以Partially Crystallized Ultrathin Interfaces between GaN and SiNx Grown by Low-Pressure Chemical Vapor Deposition and Interface Editing为题发表在ACS Appl. Mater. Interfaces上。研究获得国家自然科学基金重大仪器项目/重点项目/面上项目、中科院前沿重点项目等资助。
论文链接
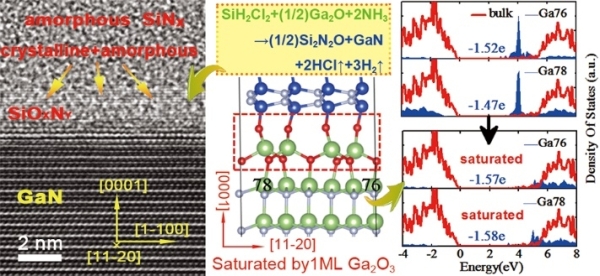
界面晶化层形成机理与原子级界面编辑
近日,中国科学院微电子研究所高频高压中心研究员刘新宇团队与中科院合肥物质科学院固体物理研究所研究员刘长松团队、微电子所先导中心工艺平台合作在GaN界面编辑领域取得进展,揭示低压化学气相沉积(LPCVD)SiNx/GaN界面晶化的形成机理,在理论上创新定义了θ-Ga2O3结构,并将1ML θ-Ga2O3薄层插入界面调控未饱和原子化学键,进而有效抑制了界面带隙电子态密度。
对于下一代平面和垂直型GaN电子器件,能否将薄膜介质集成到III-N材料中至关重要,高质量界面和对电应力的高耐受性是薄膜材料选择的主要标准和潜在挑战。目前,在III-N表面已采用多种材料作为钝化和栅极介电层以提高器件性能和可靠性,其中包括团队前期研究的LPCVD-SiNx介质,其具有高温耐受性、结构致密、无离子损伤、高TDDB特性等优势。但由于高沉积温度(约780°C)和非故意氧残留,在SiNx沉积过程中会发生复杂反应,导致界面处存在混合成分,包括非晶相和结晶相,甚至是不连续的产物。从能量角度考虑,这种扭曲的局部键和无序粗糙晶化物质会导致带隙中高电子态密度,进一步导致意外的电流崩塌或表面泄漏电流。将无序晶化区域最小化并获得晶态向非晶态的急剧转变是最小化态密度的潜在方法之一。根据之前的研究结论,LPCVD-SiNx /GaN界面之间晶化相Si2N2O形成机理与调控技术值得研究。另一方面,即使在界面上合成了完全有序的Si2N2O晶体,仍然存在较为明显的近导带态密度,需要对界面进行原子级编辑,以期找到界面原子键态饱和的定量定义,从而指导界面态抑制工作。
该研究通过高分辨率X射线光电子能谱技术,解析了LPCVD-SiNx/GaN界面反应物和生成物的化学成分,分析了界面部分晶化超薄层的形成机理;结合反应吉布斯自由能变化的可行性分析,提出了一个合理的生成Si2N2O的化学反应方程式,并认为GaN表面高能活化的Ga2O可能有助于结晶成分的合成;创新定义了θ-Ga2O3结构,并将1ML θ-Ga2O3过渡层插入Si2N2O / GaN界面超胞结构中,用于编辑界面未饱和的化学键。该项研究在理论上证明,当界面不饱和原子的有效电荷数调整到一定区间时,界面可以实现低态密度水平。
该工作以Partially Crystallized Ultrathin Interfaces between GaN and SiNx Grown by Low-Pressure Chemical Vapor Deposition and Interface Editing为题发表在ACS Appl. Mater. Interfaces上。研究获得国家自然科学基金重大仪器项目/重点项目/面上项目、中科院前沿重点项目等资助。
论文链接
界面晶化层形成机理与原子级界面编辑
打印 责任编辑:江澄
责任编辑:江澄



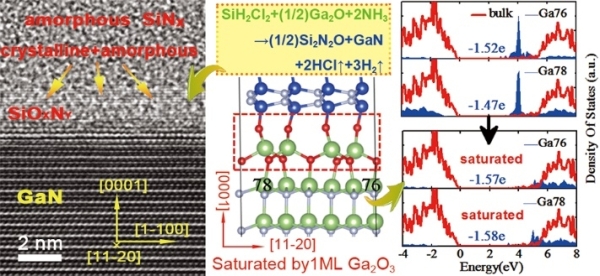

 京公网安备110402500047号 网站标识码bm48000002
京公网安备110402500047号 网站标识码bm48000002













