主要职责
中国科学院贯彻落实党中央关于科技创新的方针政策和决策部署,在履行职责过程中坚持党中央对科技工作的集中统一领导。主要职责是:
一、开展使命导向的自然科学领域基础研究,承担国家重大基础研究、应用基础研究、前沿交叉共性技术研究和引领性颠覆性技术研究任务,打造原始创新策源地。 更多+
院况简介
中国科学院是国家科学技术界最高学术机构、国家科学技术思想库,自然科学基础研究与高技术综合研究的国家战略科技力量。
1949年,伴随着新中国的诞生,中国科学院成立。建院70余年来,中国科学院时刻牢记使命,与科学共进,与祖国同行,以国家富强、人民幸福为己任,人才辈出,硕果累累,为我国科技进步、经济社会发展和国家安全作出了不可替代的重要贡献。 更多+
院领导集体
科技奖励
科技期刊
科技专项
科研进展/ 更多
工作动态/ 更多
工作动态/ 更多
中国科学院学部
中国科学院院部

语音播报

氮化镓(GaN)是一种宽禁带半导体,第三代半导体的典型代表。与第一代半导体硅基的器件相比,GaN器件具有更高耐压、更快开关频率、更小导通电阻等特性,在功率电子器件领域得到广泛应用。相关研究显示,GaN器件适用于68%的功率器件市场;在功率转换电路中应用GaN器件可消除整流器在进行交直流转换时90%的能量损失,极大提高了能源利用效率;可使笔记本等电源适配器的体积缩小,减小设备体积,提高集成度。
在实际应用中,为实现失效安全的增强模式(E-mode)操作,科研人员广泛研究了基于凹槽栅结构的MIS栅、p-GaNregrowth栅增强型GaN HEMT器件。在实际的器件制备过程中,精确控制栅极凹槽刻蚀深度、减小凹槽界面态密度直接影响器件阈值电压均匀性、栅极可靠性,在大规模量产中会直接影响器件的量产良率。
近期,中国科学院苏州纳米技术与纳米仿生研究所研究员孙钱团队博士研究生苏帅、钟耀宗等在p-GaN Regrowth器件制备技术、器件可靠性测试分析技术等方面取得进展,制备的器件阈值电压达到~1.7 V@ IDS = 10 μA/mm、开关比达5×1010、输出电流400mA/mm以上,器件综合性能优异;在栅极凹槽深度高均匀性的精确控制及减小凹槽界面态密度方面,利用自主创新的MOCVD热分解自终止技术手段实现了精确可控的栅极凹槽制备,且凹槽深度均匀性大幅提高,同时栅极界面态密度减小1~2个数量级,达到 ~1011 eV-1·cm-2 ,有助于高性能MIS、pGaN栅极增强型器件的研发。
相关成果发表在电子器件领域期刊IEEE Electron Device Letters 、ACS Applied Materials & Interfaces、IEEE Journal of Emerging and Selected Topics in Power Electronics,以及第三十二届功率半导体器件和集成电路国际会议上。主要作者为苏帅、钟耀宗,通讯作者为孙钱、副研究员周宇。研究得到国家自然科学基金、国家重点研发计划课题、中科院重点前沿科学研究计划、江苏省重点研发计划项目。

GaN HEMT 电力电子器件的应用
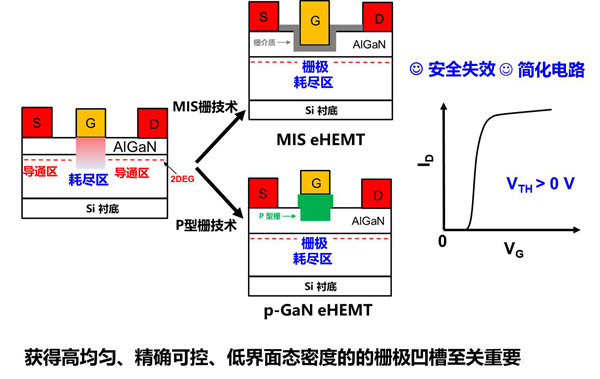
GaN HEMT 增强型器件技术路线及关键科学问题

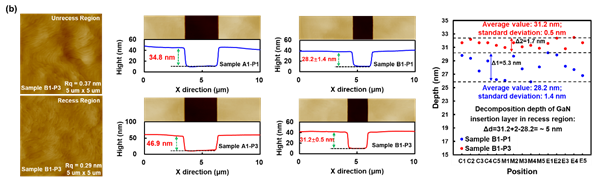

(a):MOCVD热分解实现高均匀性低界面态栅极凹槽结构的技术路线;(b):基于MOCVD热分解制备的凹槽的表面形貌,热分解自终止的验证及片上均匀性统计;(c):利用变频CV表征栅极界面态密度

© 1996 - 中国科学院 版权所有 京ICP备05002857号-1  京公网安备110402500047号 网站标识码bm48000002
京公网安备110402500047号 网站标识码bm48000002
地址:北京市西城区三里河路52号 邮编:100864
电话: 86 10 68597114(总机) 86 10 68597289(总值班室)














